我们通常购买的衬底往往会伴随着加工运输等环节不可避免的含有其他化学杂质、微粒污染物、吸附的水汽等,这些物质的存在都会影响光刻的过程以及图案的质量。
因此我们需要根据自己的实际情况对衬底材料进行彻底清洗,必要的时候需要有针对性的改变清洗方法和工艺。以下根据物质的种类介绍如何清洗样品:
水汽的吸附
对于清洁的基材,建议在120℃~150℃下进行几分钟的脱附处理,水分子通常吸附在暴露于空气湿度的表面上。原则上,如果在此之前用异丙醇或在另一个工艺步骤(金属化、氧化等)中加热至100°C以上,则可以跳过这一步。
为了最大限度脱附那些着于氧化表面(天然或热氧化的Si、石英、玻璃、大多数金属)的水汽,可将烘烤温度提高到140℃以上。在此过程中,氧化表面暴露在空气湿度下一段时间的OH键被破坏,疏水性进一步增强,光刻胶的润湿性和附着力进一步增强。
根据相对湿度和衬底的情况,水膜可以在短时间内再次吸附到基材表面。因此,后续的涂胶工艺应在烘烤后尽快进行,但不能在衬底未冷却至室温下进行。
颗粒物
为了去除颗粒污染物,建议在异丙醇(纯度VLSI或更高)中漂洗。后续不需要在去离子水中清洗,因为在去离子水(如有机杂质)清洗不够的情况下,反而会破坏异丙醇的清洗效果。
有机杂质
对于被有机杂质污染的衬底,建议采用丙酮两步法清洗,去除有机杂质,然后异丙醇清洗,在污染的丙酮在基材上形成条痕之前将其去除。同样,后续在去离子水中冲洗既无必要也不推荐。
对于强杂质(如光刻胶残留物)或较大的衬底,建议使用两步丙酮和异丙醇步骤(如下图1所示),以尽量减少杂质的残留。
“循环交换的冲洗”操作模式(丙酮容器I->丙酮容器II->异丙醇容器I->异丙醇容器II)有助于减小溶剂消耗。在某些循环中,污染较重的溶剂(I)然后被处理掉,用较干净的溶剂(II)代替,然后用新的溶剂代替。
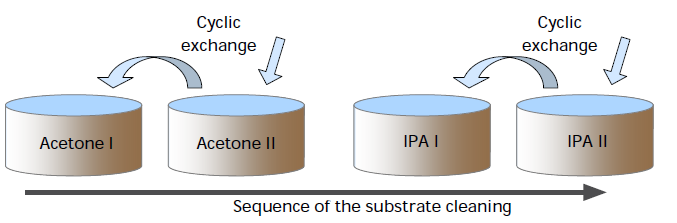
食人鱼蚀刻和RCA清洗
如果有机或金属杂质污染比较严重,同样在高温处理之前,建议对硅片进行蚀刻和RCA清洗,其顺序如下:
- 食人鱼液(H2O2 : H2SO4 = 1 : 2)中硅表面生长SiO2;
- 在1-5% HF溶液中取出SiO2,然后在RCA-1 (H2O2 : NH4OH : H2O = 1 : 1 : 5) 溶液中 70 – 75°C 下处理 10 分钟;
- 在1-5% HF中大约1.0 – 1.5nm的SiO2在被去除;
- 然后,在RCA-2 (HCl:H2O2: H2O = 1:1: 8)溶液中约80°C的温度下处理10分钟,然后选择性地浸入1-5%的HF以除去生长的SiO2 ;
上述溶液的质量均以标准浓度为准。
让然您也可以通过等离子体清洗样品表面以达到去除有机污染物的目的,但是需要注意,使用氧等离子体处理有可能使衬底材料氧化,这是我们需要注意的!
如果,您对上述衬底清洗步骤有任何心得,欢迎您在文章下方留言给我们!了解更多光刻及光刻胶知识库,欢迎关注Litho+wiki,获取更多信息……
Views: 1615

请问用IPA清洗后不再用去离子水冲洗,那衬底上会有残余的IPA吗
会挥发掉的