1. 电子束光刻应用背景
众所周知,电子束光刻是获得我们想要的纳米结构的最有效加工方式之一,被广泛应用于掩膜版加工、光通信、第三代半导体、微纳光学、微纳电子学、基础物理、超材料、量子通信和量子计算等前沿研究领域,且在这些领域的发展中发挥着重要作用。电子束光刻机也伴随着这些研究和研发的兴起变得越来越重要。
2. 电子束光刻图形化特点
光刻的基本原理是利用光或者电子束(或者离子束、X射线、同步辐射等)在感光的光刻胶(光阻、抗蚀剂)上获得目标图形,其中直写工具是产生最原始图形的基本工具,在图形最终的质量和精度方面起着重要作用(如下图1所示)。电子束光刻系统因其分辨率高和图形加工自由度高等特点在前沿领域的应用广受关注,如纳米压印模板加工、AR/VR镜片加工、光子晶体、量子计算等。以往大部分时候我们利用以电子束光刻系统为代表的光刻手段主要是利用其2D平面加工技术,但是随着微纳光学的兴起,我们对3D微纳加工的技术的需求也越来越急迫,而现有的一些加工手段很难获得纳米级的3D结构,这给我们的前沿研发带来了巨大挑战。
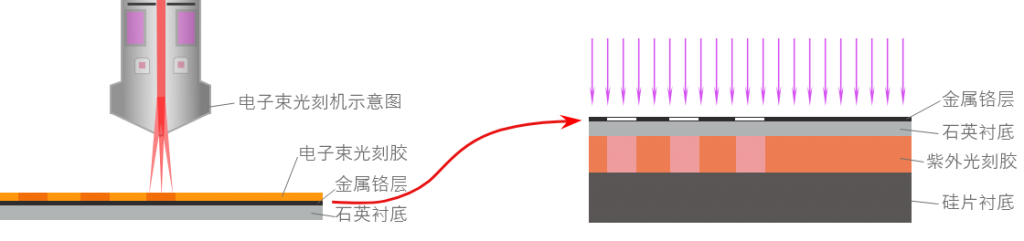
3. 3D微纳加工背景及灰度光刻
在微纳光学应用井喷出现的今天,我们对闪耀光栅、倾斜光栅、非球面透镜、菲尼尔透镜、DOE、TOF、超表面、超透镜以及光耦合微棱镜等(如下图2所示)需求的特点是:需要极高的精度和具备大面积结构加工能力。因此我们把目光锁定在电子束光刻手段,使用套刻和灰度光刻来实现3D微纳加工。套刻的方法比较好理解,就是用将结构划分为不同刻蚀深度的区域,光刻+刻蚀为依次进行,从而获得3D结构的加工方式,这种方式需要多次处理光刻胶,整个开发周期较长,套刻精度也对最后的结构影响巨大(如下图2中衍射光学元件)。
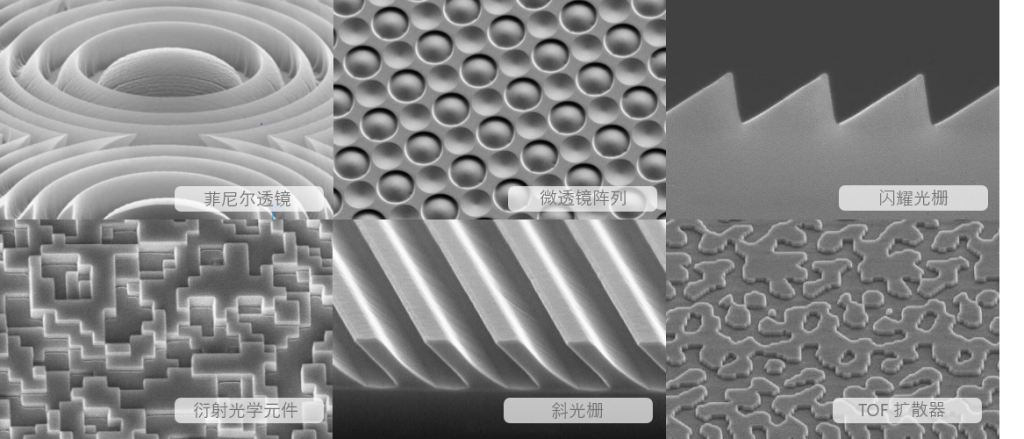
灰度光刻(gray scale lithography)就是利用光刻胶在低剂量曝光下光刻胶的不完全显影,使用不同位置给予不同的剂量从而获得3D光刻胶结构的曝光方式,这种灰度曝光不仅仅可以在电子束上实现,在激光直写或者接触式光刻(需要灰度光刻掩膜版)上也是可以实现的(如下图3所示)。
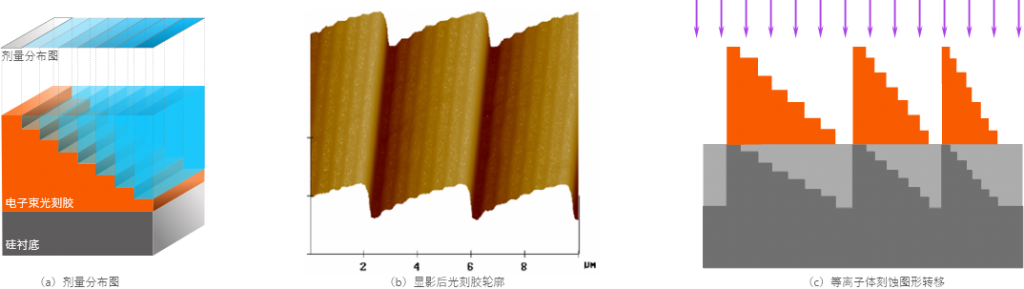
4. 电子束灰度光刻3D微纳加工方法
电子束灰度光刻是一个十分具有挑战性的工作,其难点在于选择合适的光刻胶和显影液,获得较低的对比度,另外,欠曝光的光刻胶属于聚合物的混合状态(例如PMMA,欠曝光区域的PMMA中既有长分子链的也有相对较短分子链的PMMA)这就对了显影的环境提出了较高的要求,任何环境的变化(显影液浓度、温度)等都会影响最终获得的轮廓形态,最后由于电子束与物质(光刻胶以及衬底)的相互作用,会产生临近效应,这也给最后的结果带来了不确定性。另外,利用电子束灰度光刻制作台阶状特别是灰阶不太多的结构,还是比较简单的,而针对平滑表面的(如球面)或者中间灰阶平面的表面粗糙度的处理则比较困难,需要通过工艺或者后处理来改善。下面我们将逐步介绍如何实现灰度光刻加工3D微纳结构。
(1)图形结构设计
微纳光学应用中,结构的设计往往与最终使用的材料、中间所使用的工艺直接相关,因而需要综合评估甚至是光学模拟后方可确定所需的微纳结构尺寸。例如,微透镜结构的矢高、口径等取决于最终量产过程中使用的材料(如纳米压印胶)的折射率,如果我们中途需要使用等离子体干法刻蚀来实现光刻胶结构转移至硅片衬底上,我们还需要考虑光刻胶与衬底材料的在特定工艺下的刻蚀选择比,最后才能确定所需微纳米结构的尺寸信息。

(2)光刻胶选择
前面我们已经简单介绍了灰度光刻中困难点,其中光刻胶的选择就是其中之一,一般来说我们应用于灰度光刻应用下光刻胶的选择不仅仅是选择光刻胶本身,还有其配套的显影液和显影方案,因为光刻胶种类和显影液决定了一款光刻胶的对比度。而在灰度光刻应用中我们需要选择尽可能小对比度(γ<1)的光刻胶方案,如果光刻胶的对比度过大,对应的工艺窗口非常窄,对于我们加工过程非常不利。另外,如果选择负胶,需要确保电子束能够到达光刻胶底部,否者会出现光刻胶从衬底上剥离的风险。以下是最常见的电子束正胶PMMA的对比度曲线。

(3)光刻胶对比度曲线
我们知道光刻胶的对比度曲线(参见光刻胶一般特性)可以帮我们判断一款胶在后续工艺中的表现出来一些特性,同一款光刻胶在不同的显影液以及显影条件下其对比度曲线是有差异的,如下图中电子束正胶AR-P 617在不同的显影条件下对比度曲线。结合上述光刻胶的选择,我们通常会选择灵敏度较低、对比度较低的光刻胶方案来做灰度光刻。
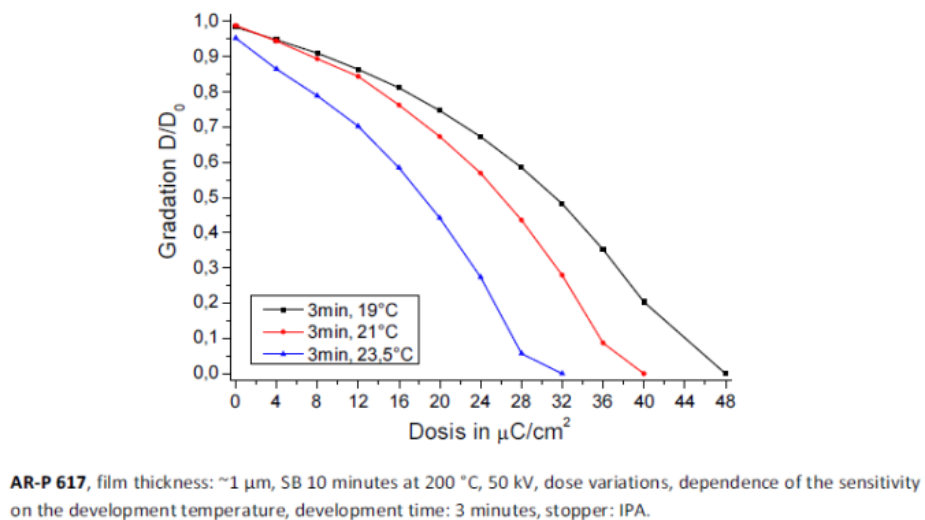
(4)曝光剂量与显影深度关系
确定下来光刻胶方案后,我们还需要结合自己的实验条件通过实验获得光刻胶在不同剂量下曝光后留膜率与曝光剂量的关系图,我们可以通过以不用的剂量曝光一系列小面积的区域阵列,显影后通过探针式轮廓仪获得对应的曲线,如下图所示:
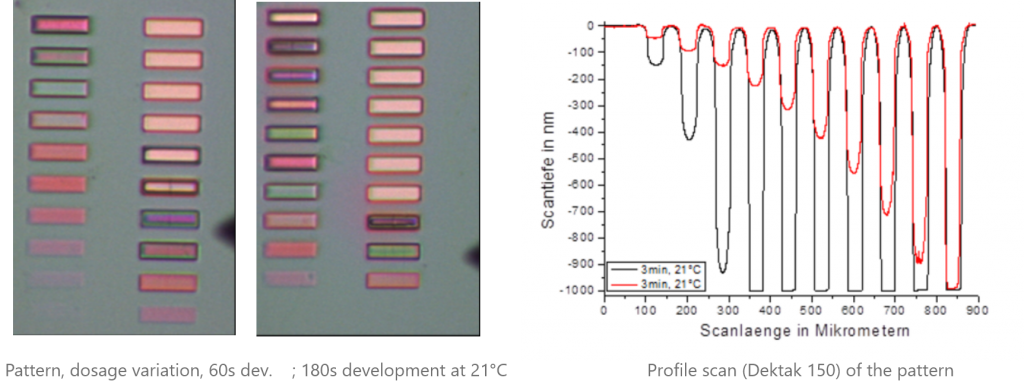
(5)曝光剂量分布
通过上述获得的留膜率与曝光剂量的对应关系,我们将设计的微纳结构信息与对比度曲线对照后即可获得所需要的剂量分布图,如下图所示。这步,我们就获得了实验优化的基础,但是由于电子束的电子散射使能量变得模糊,光刻胶的横向显影导致光刻胶的轮廓边缘形貌发生改变。这些都导致了图形的不确定性。
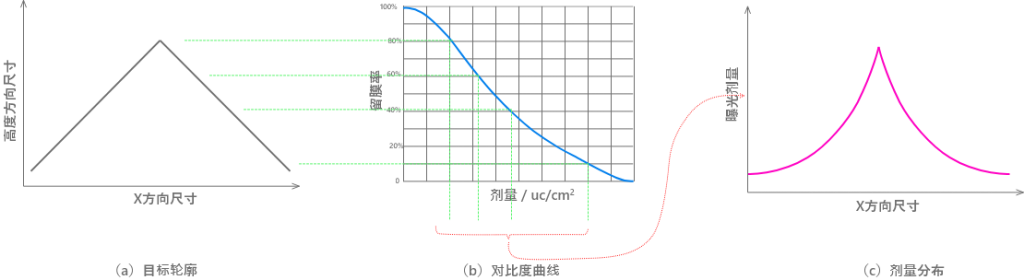
(6)重复优化与软件模拟优化
为了获得尽可能接近目标轮廓的图形,我们可以通过不断的实验已获得一些规律性的趋势,并在后续的工艺方案中进行修正,从而优化我们的图形结构。当然更便捷的方法是利用软件模拟计算,获得合适的曝光剂量分布,从而简化我们的工作流程。
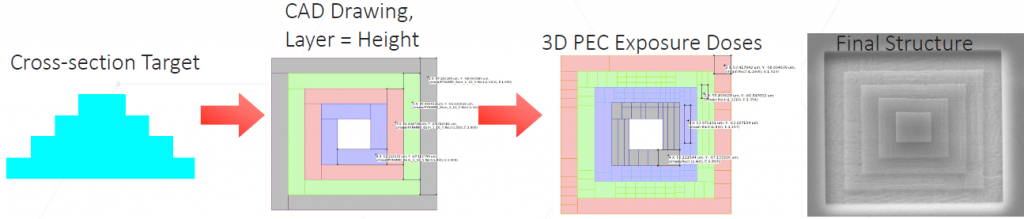
至此,我们就介绍完了使用电子束灰度光刻实现3D结构的加工,由上面的介绍我们可以知道,这里所获得的3D结构还存在点问题,因为我们将所有的斜面或者曲面都简化成一个个小台阶来处理的,而很多情况下,我需要获得表面光滑的斜面或者曲面或者要求较高的表面粗糙度。这种情况下我们又该如何处理呢?我们将在下一篇文章中探讨电子束灰度光刻3D微结构的优化。
Views: 1334

Leave A Comment?