概述
PMMA(聚甲基丙烯酸甲酯)和Copolymer(共聚物,如MMA或者MMA和MA的共聚物)是最常的电子束光刻胶之一。也是第一款被发现可用于电子束光刻的聚合物。他是一种标准的正性电子束光刻胶,具有高分辨率(<10nm)和高对比度,灵敏度较低的特点(约为100uc/cm2 @20kV)。与绝大部分电子束光刻胶一样,其临界剂量与加速电压成正相关,利用特殊的显影工艺可以获得3-7nm的极限线条。原始的PMMA是白色粉末状固体,可将其溶解在特定的溶剂中实现涂胶。早期的溶剂是氯苯,其具有良好的溶解性能,但是氯苯是易燃且不安全的有机溶剂,后来商业化的PMMA电子束光刻胶均采用更加安全的苯甲醚作和乳酸乙酯作为溶剂。PMMA的灵敏度还与其相对分子质量有关,一般来说,相对分子质量越大,灵敏度越低,相对分子质量越小,灵敏度越高(其灵敏度的差异一般在20%以内)。高相对分子质量的PMMA之所以灵敏度较低,是因为其在显影液中的溶解速率较低。目前商业化的PMMA电子束的光刻胶常常有50K,200K,495K,600K和950K。需要注意,灵敏度高固然可以提高电子束直写的效率,但是也会导致分辨率的降低。当然,PMMA的灵敏度还与显影液的浓度有关。标准的显影液配比通常是MIBK:IPA=1:3,增加MIBK的比例可以提高PMMA的灵敏度,但是会降低分辨率,显影液浓度对灵敏度与分辨率的影响如下表所示:
表1 显影液浓度对PMMA灵敏度和分辨率的影响
| 显影液浓度(MIBK:IPA) | 灵敏度 | 分辨率 |
| 1:3 | 低 | 非常高 |
| 1:2 | 中 | 很高 |
| 1:1 | 高 | 高 |
| 纯MIBK | 很高 | 低 |
PMMA的正常曝光剂量约为50-500uc/m2,但是在非常高的曝光剂量下(如:10倍于正常的曝光剂量)PMMA会由正胶变成负胶,即负胶效应。很多人认为这种负胶效应是因为PMMA发生了交联反应,但是研究表明其更多的是因为PMMA发生可碳化的过程。PMMA的感光波段为<300nm,因此他不仅对电子束感光,对深紫外和X射线等光源也是感光的,PMMA也是X射线光刻中常用的光刻胶之一。对于深紫外光刻来说,其相对于其他类型的深紫外光刻胶,PMMA的灵敏度要低的多,在248nm的深紫外光波长下,PMMA所需的曝光剂量大约为500mJ/cm2.Copolymer通常是MMA或者MMA与MA的共聚物,其性质与PMMA相似,但是其灵敏度相比于PMMA高很多,通常是PMMA的3-4倍,不同相对分子质量的PMMA以及copolymer之间的灵敏度差异,往往可以用来构建双层lift-off方案,或者双层甚至三层搭配构建T-gate工艺方案。
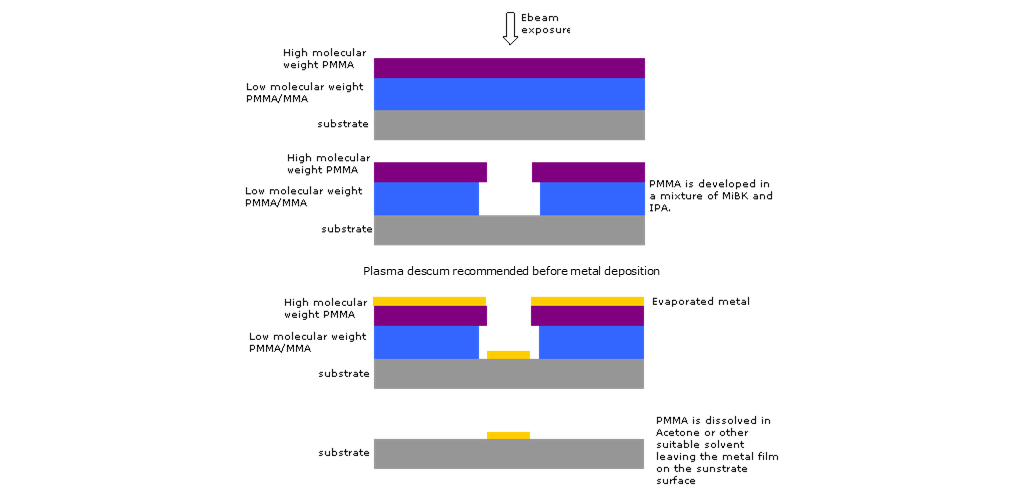
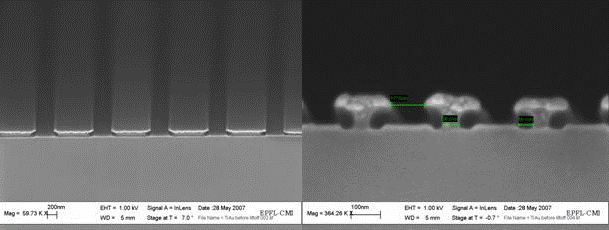
PMMA虽然具有高分辨率的特点,而且成本相对比较便宜,但是其缺点是抗等离子体干法刻蚀能力差,不如大部分紫外光刻胶,其与SiO2的可实现选择比约为1:1,所以PMMA常常被用于作为金属剥离的应用中。另外,随着微纳光学领域的发展,PMMA在灰度光刻应用中也有着举足轻重的意义,但是需要注意,灰度光刻通常要求对比度低的显影方案,因而我们需要为此配置一些对比度较低的显影配方(如乙醇和水的显影液配方)。伴随着二维材料研究的火热,PMMA也在二维材料转移中有着重要的应用。因此,其仍然使我们最常用的电子束光刻胶之一。
曝光剂量
对于较大结构(大于 1µm),100kV 时的清零剂量约为 600µC/cm2,对于小结构的lift-off工艺,其清零剂量可高达约 3000µC/cm2。
分辨率
使用高电压系统,且工艺良好的情况下,单层较薄的PMMA,其最佳分辨率可达<10nm。PMMA/PMMA 双层可获得的最佳分辨率约为 10nm。< 20nm 也是比较容易获得的。
化学耐受力
- PMMA/MMA 耐水、IPA(注意,水和IPA的混合物可作为PMMA的显影液)、甲醇、HCl、稀释 NH3、稀释 H2SO4、短时间的稀释 HF、短时间的H3PO4、稀释 HNO3,重要的是它还耐 TMAH 基显影液。
- PMMA/MMA 会受到丙酮、氯苯、浓 NH3、HF 的攻击(超过几秒后,取决于强度)。
快速流程
在处理之前,选择 2 个烧杯放入 MMA/PMMA 托盘中,第一个用少量显影剂冲洗,第二个用 IPA 冲洗。
| 步骤 | 描述 | 工艺/参数 |
| 1 | 衬底烘烤 | 高功率 O2 等离子 5 分钟,或在 180°C 热板上 5 分钟 |
| 2 | 衬底冷却 | 1分钟 |
| 3 | MMA旋涂 | 其厚度约为待剥离金属厚度~2 倍,旋涂 |
| 4 | MMA烘烤 | 在 180°C 的热板上 5 分钟 |
| 5 | 衬底冷却 | 1分钟 |
| 6 | PMMA 950K旋涂 | 在旋涂机上 |
| 7 | PMMA 950K烘烤 | 180°C 加热板上 5 分钟 |
| 8 | 曝光 | 在电子束光刻机上 |
| 9 | 显影 | 在湿台上进入 MIBK:IPA 1:3, 1 分钟 |
| 10 | 定影,干燥 | 用 IPA 冲洗 1 分钟并用氮气吹干 |
参考资料:
1. 《微纳米加工技术及其应用》,崔峥,北京,高等教育出版社2005.6;
2.《微纳加工及在纳米材料与器件研究中的应用》,顾长志,北京,科学出版社,2013.6;3.https://www.epfl.ch/research/facilities/cmi/equipment/ebeam-lithography/raith-ebpg5000/ebeam-resists-available-in-cmi/mma-pmma-resists/
4.https://www.allresist.com/portfolio-item/e-beam-resist-ar-p-632-series/
5.https://kayakuam.com/products/pmma-positive-resists/
如果您对上述技术兴趣的话,欢迎与我沟通交流。 如果您想了解更多光刻及光刻胶知识库,欢迎关注Litho+wiki,获取更多信息……
Views: 3950

Leave A Comment?