概述
ZEP胶是一种苯乙烯甲基丙烯酸酯基的电子束正胶, 因其相比于PMMA具有更好的耐干法刻蚀能力,因而在电子束光刻应用中常用作干法刻蚀掩膜使用。它具有很高的分辨率,和相比于PMMA更高的灵敏度。因为它的主要用途是干法蚀刻应用,因而通常单层使用并尽可能获得垂直侧壁的光刻胶结构。
分类
电子束正胶
剂量
高灵敏度意味着低剂量。典型的ZEP剂量在160 – 400 µC/cm2 之间。
分辨率
独立特征的分辨率可低于30nm。
功能
选择比是衡量抗干法刻蚀的重要参数,对于Si衬底,ZEP胶对于较大的特性结构,可以达到≈16:1 Si:ZEP。对于SiO2,选择率为≈4:1,SiO2为5:1。ZEP的湿腐蚀选择性与PMMA相似。
注意:长时间干法刻蚀后,ZEP胶会发生变性导致无法使用湿法去胶,甚至是氧等离子体处理也会比较困难,另外,这款胶对于石英、III-V族衬底粘附性不好,需要做增附处理,否则容易发生裂纹、漂胶等现象。
一般工艺
显影过程至关重要,有几个选择: 对于小于300nm的胶膜,我们可以使用n-amyl-acetate显影1分钟,对于较厚的膜,最好显影2分钟,以确保你已经完全显干净了。我们通常使用90:10 MIBK:IPA 立即冲洗显影后的样品。但是注意这个MIBK:IPA也会显影ZEP,所以使用时应该小心处理并及时冲洗,用氮气吹干。
在处理之前,取2个烧杯。用少量显影剂(醋酸戊酯)冲洗第一遍,用ZEP冲洗溶液(90:10 MiBK:IPA)冲洗第二遍。
| 步骤 | 描述 | 工艺参数 |
| 1 | 衬底处理 | 高功率下氧等离子处理5min或者在180℃热板烘烤5min |
| 2 | 衬底冷却 | 1min |
| 3 | 涂胶 | 参考旋涂曲线 |
| 4 | 前烘 | 180℃ 热板 5min |
| 5 | 曝光 | 160 – 400µC/cm2 |
| 6 | 显影 | 在湿法台中 Amyl-Acetate 显影液中显影1-2min |
| 7 | 冲洗干燥 | 1min 90:10 MiBK:IPA溶液冲洗,然后氮气枪吹干 |
旋涂曲线
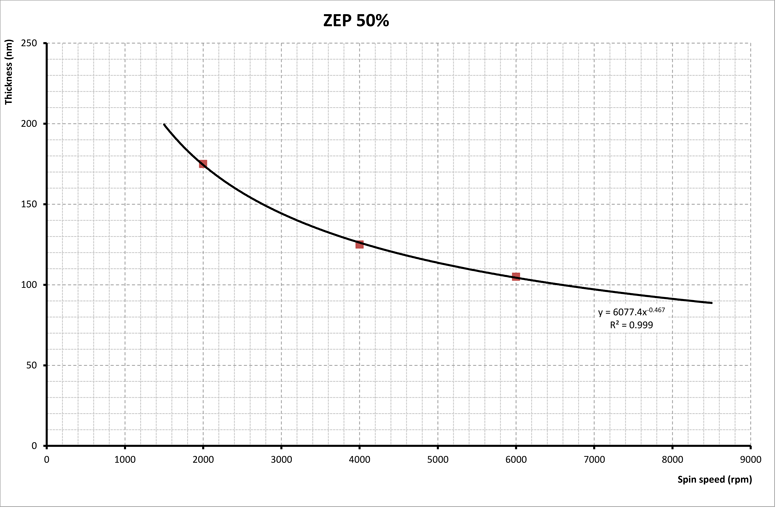

本文整理自网络: https://www.epfl.ch/research/domains/cmi/cmi-home-page/equiment/ebeam-lithography/raith-ebpg5000/ebeam-resists-available-in-cmi/zep-resist/
如果您对上述技术有兴趣的话,欢迎与我沟通交流。 如果您想了解更多光刻及光刻胶知识库,欢迎关注Litho+wiki,获取更多信息……
Views: 3143

Leave A Comment?